红外测厚仪
涂层三要素
以前的红外线测厚仪的测量物接近红外线波长厚度(20μm以下)时,由于光干涉的影响测量精度不良,特别是测量物为平滑物时,厚度在10μm以下时完全不能测量。
并且,不仅仅是光干涉影响,测量物表面反射和散乱等的影响也不能忽视。这样就会有一种错误的想法,即测量膜的厚度等时,准确度明显不如放射线方式。
本公司独自的P偏光方式红外线测厚仪可以解决这样的难题。
如下图所示那样,P偏光是指相对入射面平行成分的光波,这个光波用偏光角(Brewster角)入射后不产生表面反射光。为了减少来自水面的反射,需要戴偏光眼镜(偏光眼镜),这样就容易理解了。
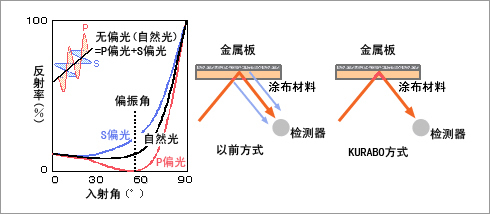
上图是P偏光方式红外线测厚仪传感器头的构成图,将偏光镜(偏振片) 设置在干涉滤波器后面,将偏光角入射P偏光。采用这种方式,以往用红外线方式难测的金属镜面上树脂薄膜和膜上极薄涂层等也能进行高精度的测量了。下图为使用P偏光的膜厚仪结构图。
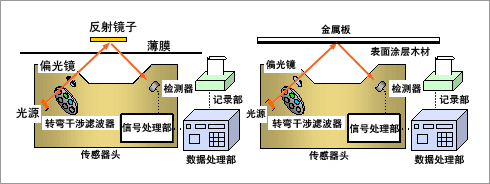
应
用
知
识
屋






